Crystal analysis by EBSD BGA
The EBSD method allows for the estimation of crystal states and residual stresses! Here is an example of BGA analysis.
Here is an example of the analysis of BGA (Ball Grid Array). In the observation using a microscope, both optical microscopy and SEM are employed. In the crystal analysis using the EBSD method, we utilize the Phase map, Sn Grain map, Sn IPF map, and Sn GROD map, which allow for the inference of crystal states and residual stresses. 【Overview】 ■ Crystal analysis using the EBSD method - Phase map - Sn Grain map - Sn IPF map - Sn GROD map *For more details, please refer to the PDF materials or feel free to contact us.
- Company:アイテス
- Price:Other

![[Contract Analysis] Laser Microscope (High-Precision 3D Measurement & Color Observation)](https://image.mono.ipros.com/public/product/image/983/2000535358/IPROS38656653090744213031.png?w=280&h=280)


![[Data] Cross-sectional observation of neodymium magnets using a tabletop SEM (scanning electron microscope)](https://image.mono.ipros.com/public/product/image/5fd/2000561894/IPROS71970030245724406256.png?w=280&h=280)







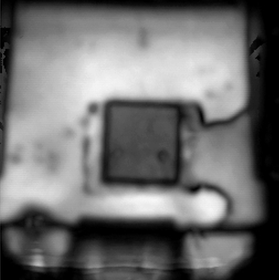



![[EMS] Emission Microscopy Method](https://image.mono.ipros.com/public/product/image/ebd/387108012/IPROS78188100613521420358.jpeg?w=280&h=280)
![[SIM] Scanning Ion Microscopy Method](https://image.mono.ipros.com/public/product/image/d09/387108028/IPROS2308410282720757772.jpg?w=280&h=280)
![[Analysis Case] Evaluation of the Diffusion Layer Structure of Bipolar Transistors](https://image.mono.ipros.com/public/product/image/bfa/2000026058/IPROS4050912517421912345.jpg?w=280&h=280)
![[Analysis Case] Evaluation of Specific Crystalline Grains in CIGS Thin-Film Solar Cells](https://image.mono.ipros.com/public/product/image/671/2000026084/IPROS9004478180482919482.jpg?w=280&h=280)
![[Analysis Case] Evaluation of the Mixed State of the Active Layer in Organic Thin-Film Solar Cells](https://image.mono.ipros.com/public/product/image/977/2000026085/IPROS174033469563361764.jpg?w=280&h=280)
![[Analysis Case] Observation of Heterojunction Interface in CIGS Thin-Film Solar Cells](https://image.mono.ipros.com/public/product/image/eb6/2000026099/IPROS6338370875583078818.jpg?w=280&h=280)
![[Analysis Case] Resistance Evaluation of Heterojunction Interface in CIGS Solar Cells](https://image.mono.ipros.com/public/product/image/985/2000026101/IPROS1055062992217362280.jpg?w=280&h=280)
![[Analysis Case] Cross-Section Observation of Organic Thin-Film Solar Cells](https://image.mono.ipros.com/public/product/image/225/2000026116/IPROS1950721786299617987.jpg?w=280&h=280)
![[Analysis Case] Observation of Crystal Structure of Multicomponent Metallic Nanoparticles by TEM](https://image.mono.ipros.com/public/product/image/a51/2000026120/IPROS35525304543880823232.jpeg?w=280&h=280)
![[Analysis Case] Cross-sectional Observation of TEM/SEM Organic EL and Gate Oxide Film](https://image.mono.ipros.com/public/product/image/7c3/2000026123/IPROS15728510700350494850.png?w=280&h=280)
![[Slice&View] Three-Dimensional SEM Observation Method](https://image.mono.ipros.com/public/product/image/af3/2000240805/IPROS5186273045603044673.jpg?w=280&h=280)
![[SMM] Scanning Microwave Microscopy Method](https://image.mono.ipros.com/public/product/image/c8e/2000240833/IPROS87788558864251994557.png?w=280&h=280)